美國人眼裏的先進封裝現狀
本文來自格隆匯專欄:半導體行業觀察
摘要
傳統半導體行業縮小器件和降低成本方法正在發生重大轉變,芯片設計人員積極尋求新的技術解決方案,以提高成本效益,同時將更多功能集成到硅片上。異構集成(HI)是一種可行的解決方案,利用先進的封裝技術,實現各個組件的獨立設計和製造,並分別使用最合適的工藝。然而,採用 HI 會帶來設計和安全性的挑戰;為了實現HI,先進封裝的研發至關重要。現有的研究提出了先進封裝供應鏈中可能存在的安全威脅,因為大多數外包半導體組裝和測試(OSAT)設施/供應商都不在美國。為了應對不斷增長的半導體需求並確保安全的半導體供應鏈,美國政府做出了巨大努力將半導體制造設施遷至境內;然而,美國的先進封裝能力也必須提升,以實現建立安全、高效、有彈性的半導體供應鏈的願景。
我們的研究目的是:找出美國先進封裝供應鏈中可能存在的瓶頸和薄弱環節。本文作者是包括了來自佛羅里達大學、邁阿密大學和 Skywater Technology Foundry 的研究人員。
Introduction(介紹)
電子設備的普遍存在正在深刻地改變我們的生活方式和工作方式,並深深地融入我們的日常生活中。在當今的數字驅動經濟中,高速設備和無縫連接的廣泛使用產生了大量數據。各種關鍵系統,包括自動駕駛、數據中心和人工智能 (AI) 系統,都依賴於捕獲、存儲和分析這些大數據來實現數據驅動的交互。集成電路 (IC) 在支持數據處理、高性能計算和無線通信的發展方面發揮着關鍵作用。當今的尖端 IC 提供高帶寬存儲器、多個處理內核和高速輸入/輸出 (I/O) 端口,這些尖端 IC 的出現主要歸功於摩爾定律的持續演進,該定律推動半導體行業不斷生產更快、更小且更具成本效益的IC。然而,由於製造成本上升、功耗挑戰以及與先進技術節點相關的良率問題,這一長期有效的定律逐漸達到瓶頸。
為了應對傳統CMOS(互補金屬氧化物半導體)技術微縮化所面臨的挑戰,2015年,國際半導體技術路線圖(ITRS)提出了一種前瞻性戰略,以延續CMOS技術的發展。這一願景的核心是採用異構集成 (HI) 作為可行的解決方案。HI 將單獨設計和製造的組件集成到基板上,使它們能夠像片上系統 (SoC) 一樣運行。
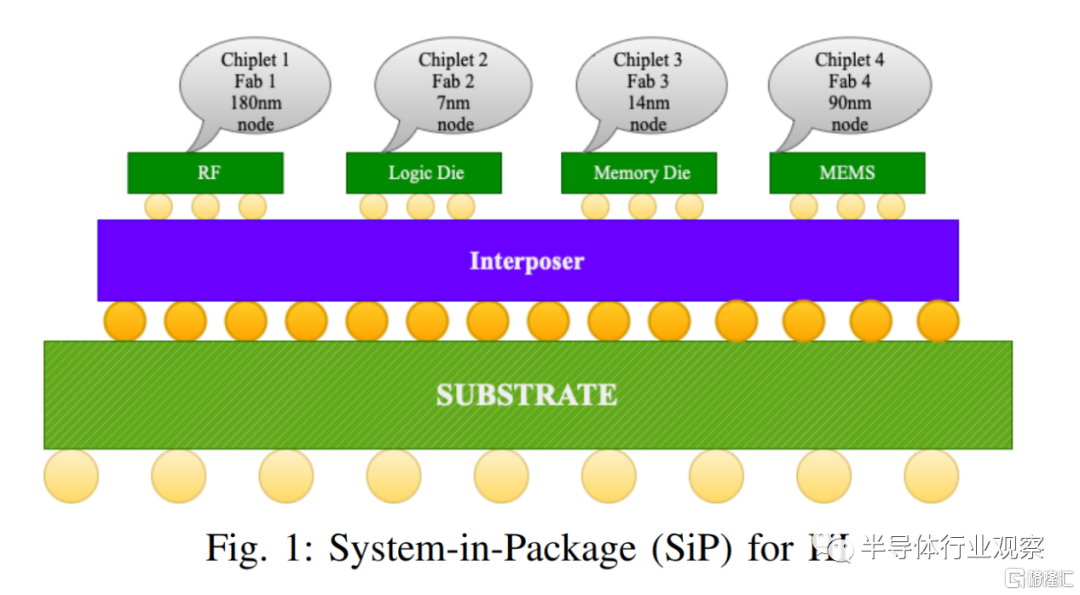
HI 將具有不同技術節點和功能的組件合併在一起,形成更先進的組件,稱為多芯片模塊 (MCM) 或系統級封裝 (SiP)(圖 1)。SiP 提供了擴展的功能和改進的操作特性,這是單芯片 SoC 方法難以實現的。芯粒、有源/無源部件和MEMS器件等組件可以統一封裝到SiP中。例如,芯粒是單獨製造的硅片,專門為內存、模擬混合信號處理、射頻 (RF) 或處理器等目標功能而設計。SiP技術可以通過中介層上芯粒的相鄰放置 (2.5D) 或垂直堆疊 (3D) 進行集成。
雖然HI具有許多優勢,但仍需要進一步的研究和開發來提高其有效性。為了實現HI的願景並延續摩爾定律,需要標準化互連接口和通信協議,確保安全設計。例如,封裝方法應該更有效地利用空間來適應更小的外形尺寸。這就是為什麼傳統的封裝技術不足以繼續發展HI,從而延續摩爾定律。此外,芯粒互連接口的設計必須滿足速度、功耗和減輕串擾的特定標準。高性能計算、5G 和人工智能的影響導致半導體速度提高、互連密度提高、焊盤間距減小、芯片尺寸擴大以及功耗增加,需要垂直堆疊芯片,以實現進一步的規模化和更快的互連,例如開發2D、2.5D和3D堆疊。這些因素對傳統封裝技術提出了挑戰,大量關於先進封裝的研究正在進行,以滿足HI的要求。
許多半導體領域的巨頭,包括英特爾、美光和三星等集成設備製造商(IDM),IBM和AMD等無晶圓廠的設計公司,台積電和三星等代工廠,以及Amkor和台積電等OSAT廠商,都深度參與其中。例如,AMD EPYC和Intel Lakefield處理器是3D SiP的商用示例。美國國防高級研究計劃局(DARPA)的通用異構集成和IP重用策略 (CHIPS) 計劃擁有類似的願景,該計劃旨在推進可靠微電子技術,以滿足美國國防部 (DoD) 的應用和技術要求。該計劃促進微電子領域內不同設計和技術的集成,確保可靠性和安全性。儘管大力推動芯片製造的發展,但也必須同樣重視美國先進封裝的能力,以充分確保半導體供應鏈的安全。然而,美國目前僅佔先進封裝市場總份額3%,其餘封裝均在海外完成,這可能會削弱美國半導體供應鏈。在美國發展先進封裝能力是確保半導體供應鏈安全的主要且必要的步驟之一,為此,需要對先進封裝供應鏈的每個階段以及每個階段的主要參與者進行嚴格審查,以充分了解美國先進封裝生態系統的當前結構,並找出可能存在的對該生態系統的穩定和安全構成威脅的瓶頸。
總之,我們分析了美國先進封裝生態系統的現狀以及緩解當前先進封裝供應鏈帶來的硬件安全問題的可能對策,貢獻如下:
1.我們分析了美國本土先進封裝製造能力。
2. 我們調查了美國先進封裝能力在各個重要應用領域對海外資源的依賴程度。
3. 我們概述了美國半導體晶圓製造當前的業務發展計劃,並強調了專門針對先進封裝業務的類似計劃的必要性。
4. 我們確定了發展安全的美國先進封裝供應鏈的主要要求。
本文主要分析美國先進封裝供應鏈生態系統及其能力(圖2)。本文的結構如下:第Ⅱ部分提供了有關HI和先進封裝的背景和驅動因素的信息。第Ⅲ部分介紹美國先進封裝供應鏈。第Ⅳ部分探討了將先進封裝業務轉移到美國的一些經濟和商業發展方面的問題。第Ⅴ部分提供了確保美國先進封裝供應鏈安全的路線圖。最後,第Ⅵ部分總結了本文。
Backgroud(背景)
A.Motivation of HI(異構集成的驅動因素)
為了跟上超越摩爾 (MtM) 的步伐,HI對於提高較小節點的性能和良率、降低半導體的功耗和成本以及減少芯粒之間的延遲至關重要。半導體行業積極推進HI有幾個重要的驅動因素:
1)HI 的特徵:DARPA 確定了HI創新的三個主要驅動力。首先,HI 通過將來自不同技術節點和代工廠的芯粒集成到通用中介層上來實現技術多樣性。這允許將具有不同技術水平的芯粒組合起來,實現將較新和較舊的芯粒集成到同一封裝中;其次,HI 通過將具有不同功能的芯粒集成到單個封裝中來支持功能多樣性,這使得 SiP 解決方案的設計能夠整合內存、邏輯、模擬 I/O 和 MEMS 傳感器芯粒,從而實現模塊化和定製設計;最後,HI 允許材料多樣性,這意味着各個芯粒可以由不同的材料製成,只要它們不會對系統的功能產生不利影響,這種靈活性可以針對特定功能優化芯粒,並增加新材料的應用。總體而言,HI 促進不同技術、功能和材料的芯粒集成,從而提高半導體系統的性能、成本效益和設計靈活性。
2)摩爾定律的延續:幾十年來,摩爾定律一直是半導體行業創新的基石,通過每兩年將 IC 晶體管密度翻一番來推動產業進步。然而,由於在縮小晶體管尺寸(例如量子現象)和不斷增加的製造費用方面遇到障礙,人們對該定律的持續適用性越來越持懷疑態度。因此,諸如 HI 之類的新穎策略應運而生,從根本上改變了封裝和設計方法,並提供了看待摩爾定律的新視角。這些創新技術並沒有專門強調晶體管密度,而是優先考慮功能密度作為性能指標,從而在行業內帶來新的視角、有價值的見解和更準確的預測。

3)提高良率以降低成本:通過將已知良好的芯片或芯粒集成在一起,HI 有望提高 SiP 解決方案的良率。技術進步促進了集成和堆疊良率的提高、同時降低了製造和研究成本。為了提高芯片良率和鍵合質量,有人建議採用Collective die-to-wafer bonding(一種鍵合方式)。此外,在 SiP 開發中利用成熟工藝節點的芯粒可以減少硅後驗證的必要性,從而降低開發成本。現有研究表明,在高性能 3D-IC 製造方面也有望實現高可靠性和高良率 。
4)尺寸最小化:採用 2.5D 和 3D 封裝技術實現了更小的外形尺寸和更低的尺寸要求。這種尺寸減小是通過將多個芯片集成到單個封裝中來實現的,從而無需使用印刷電路板 (PCB) 上的跡線進行單獨連接,因此,這些集成技術中的互連更小,從而提高了速度並降低了功耗。2.5D封裝比傳統封裝實現了更高的功能密度,傳統封裝中多個芯片並排放置在頂部中介層上。儘管如此,其在功能密度方面仍低於 3D 封裝所達到的密度,因為後者涉及垂直堆疊芯片,然而,這也給管理由堆疊芯片引發的的熱問題帶來了挑戰。因此,在 HI 中使用 2.5D 和 3D 封裝技術可以實現緊湊的外形尺寸、增強的性能、高製造良率並降低芯片的總體面積要求。
5)利用 SiP 技術增強性能:隨着單芯片方法中晶體管密度的增加所帶來的性能提升趨緩,HI 可以通過在 SiP 中集成多個芯片來延續摩爾定律。其通過提高內存訪問速度來提高性能,例如,3D 封裝技術支持 CPU 和內存芯片的堆疊,由於芯片之間的互連較短,從而增強了內存帶寬並減少了傳輸延遲。提高中介層的通信質量和互連是目前的一個研究重點,甚至有人建議引入有源中介層,將基於晶體管的邏輯電路嵌入中介層本身,進一步提高 SiP 的功能密度。
B.Advanced packging to enable HI(先進封裝)
在單個封裝中集成多個芯片或芯粒的必要性引起了人們對先進封裝技術開發的極大關注,半導體工程師和物理學家投入了大量精力進行研發。在更小的佔地面積內容納更多數量的硅芯片需要垂直和水平堆疊,包括額外的引線鍵合、密集封裝的小型凸塊、更高的佈線複雜度以及來自相鄰信號路徑的潛在干擾。各種封裝技術的出現可以解決這些設計挑戰,從而推進 HI的發展。下面討論一些常見的封裝技術:
1)傳統封裝:傳統封裝裝是指已廣泛使用的傳統封裝方法。這些技術包括雙列直插式封裝 (DIP)、四角扁平封裝 (QFP) 和小外形集成電路 (SOIC)。雖然傳統封裝很好地服務於該行業,但它在尺寸、功耗和信號完整性方面存在一定的侷限性。然而,傳統封裝仍然在特定領域得到應用,例如低成本設備或性能要求較低的應用。
2)倒裝封裝:為了增強芯片的性能和效率並減少互連,需要將芯片放置得更近。在倒裝芯片球柵陣列 (FCBGA) 的封裝中,芯片或者天線放置在封裝的表面上,數字、模擬或射頻IC以單片方式集成到球柵陣列基板的底部。這種方法可以提高電源效率並提高數據傳輸速率,然而採用這種方法後,熱管理成為新的挑戰。為了改善連接性並減少寄生,引入了微凸塊。
3)晶圓級封裝 (WLP):晶圓級封裝 (WLP) 是標準芯片封裝方法之一,其中薄金屬層用於創建再分佈層 (RDL)。此外,扇出晶圓級封裝 (FOWLP) 已成為毫米波微電子封裝的流行方法,FOWLP 通過減小封裝的尺寸和厚度,實現了無基板設計,從而增強了射頻性能並提供了更大的設計靈活性。然而,由於使用具有不同熱膨脹係數 (CTE) 的材料,翹曲對 FOWLP 提出了重大挑戰。為了解決這個問題,嵌入式晶圓級球柵陣列(eWLB)已成為一種流行的的 FOWLP 技術,實現以合理的成本進行大批量生產。
4)2.5D 封裝:在 2.5D 封裝中,單獨的中介層位於芯粒和封裝基板之間。封裝應用的流行趨勢主要集中在將尖端邏輯和存儲元件集成到單個封裝中。在這種情況下,內插器的主要功能是促進這些設備之間的高速數據通信。
2.5D 封裝的一個很好的例子是台積電開發的晶圓上芯片 (CoWoS)。在 CoWoS 中,多個小芯片或芯片堆疊在硅中介層頂部,硅中介層使用微凸塊或硅通孔 (TSV) 連接到基板 [19]。最開始使用倒裝芯片或引線接合技術將芯片接合到中介層,此後將中介層附着到基板上。中介層面向芯片的一側通常包括多個金屬層或 RDL,它們將來自芯粒上的 I/O 焊盤的電信號分配到硅中介層上的相應焊盤。在集成不同的芯粒(例如存儲器、處理器和基於 MEMS 的傳感器)時,基於中介層的 2.5D 封裝特別有價值。多家公司開發了自己的 2.5D 封裝解決方案,包括內存、處理器和基於 MEMS 的傳感器。中介層也採用了多種材料,包括IBM的直接鍵合異構集成(DBHi)、台積電的本地硅互連(LSI)和日月光的堆疊硅橋扇出基板上芯片(sFO CoS)等。
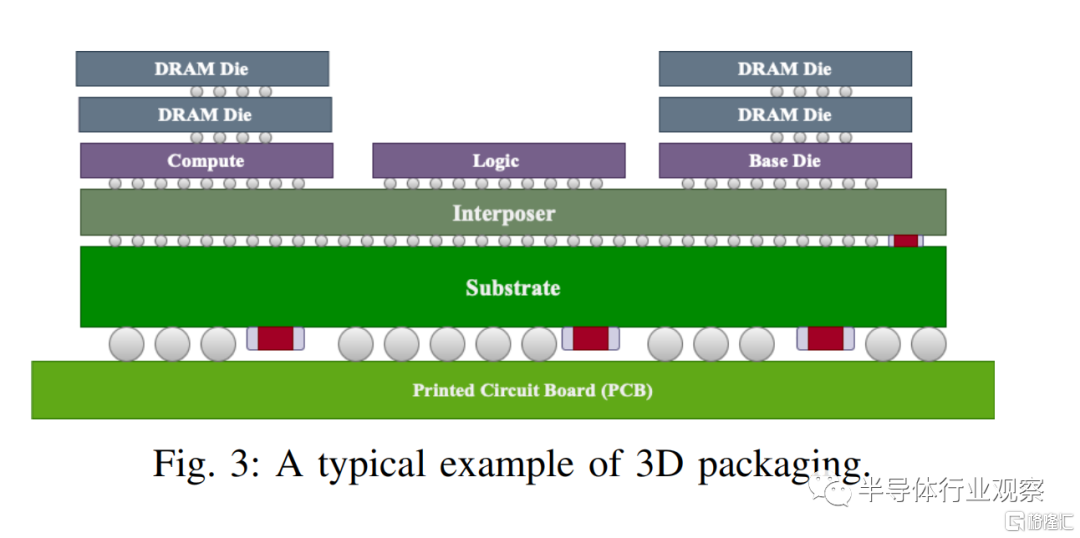
2.5D 封裝的另一種方法涉及使用“橋”在相鄰芯片之間建立連接。EMIB(嵌入式多芯片互連橋)是基於橋的 2.5D 封裝的一個示例。在此方法中,橋單獨製造並嵌入封裝基板的空腔內,一些文獻將這種基於橋的先進封裝解決方案歸類為2.3D封裝結構,採用具有高 I/O 密度的硅塊來創建這些“橋樑”,促進彼此靠近的芯粒之間的互連。由於與基於中介層的 2.5D 封裝相比,這種方法具有成本效益,各公司正在積極探索開發自己的橋接解決方案。
5)3D 封裝:3D 封裝技術通過將一個芯片放置在另一個芯片的頂部來促進半導體芯片的堆疊和互連,通常採用稱為 TSV 的垂直連接(圖 3),這種方法通常用於在處理器上堆疊存儲器或模擬和數字集成電路。英特爾的 Foveros [21] 是 3D 封裝技術的一個典型例子,它是一種芯片上芯片 (DoD) 封裝,其中使用 TSV 和微凸塊堆疊不同的功能芯片,以在各層之間建立電氣連接。3D 封裝的另一種形式是層疊封裝 (PoP),它通常涉及垂直連接兩個封裝芯片並通過封裝通孔 (TPV) 連接它們。PoP 技術在便攜式設備中使用的成像傳感器和芯片中得到了廣泛的應用。
美國先進封裝供應鏈
通過引入 CHIPS(為生產半導體創造有益的激勵)法案,美國政府表達了將半導體晶圓製造設施引入國內的願望和承諾。然而,要充分保障整個半導體供應鏈的安全,後端運營也不容忽視,同時重視發展國內先進封裝產能也至關重要。對美國現有封裝能力的嚴格審查表明,傳統封裝有足夠的能力,因此開發具有先進封裝能力的 OSAT(外包半導體組裝和測試)更有意義。然而,美國在全球市場的份額僅為3%,先進封裝產能落後,因此提高美國先進封裝製造能力非常重要。為了實現健康、蓬勃發展的美國先進封裝供應鏈的願景,首先必須審視美國先進封裝生態系統的當前結構、能力、離岸依賴和潛在弱點。圖 2 列出了美國先進封裝生態系統中的代理,並概述了這些代理之間的關係。接下來將描述這些實體的角色,並提供著名的陸上和離岸(灰色徽標)參與者的説明性示例。

1)SiP OEM/Designer:原始設備製造商 (OEM) 是指設計和製造用於另一家公司最終產品的產品或組件的公司。SiP 設計人員或 OEM 根據自己的需求為其 SiP 制定規格,或者直接從 Chiplet 設計人員處採購 SiP,例如,微軟從 AMD、NVIDIA 或英特爾等芯粒設計商處購買芯片用於其數據中心。另一方面,特斯拉可能會設計一個 SiP,並將其外包給小芯片 OEM 進行製造,或者直接從英特爾、AMD 和德州儀器 (TI) 採購芯片用於其自動駕駛汽車。
2)Chiplet OEM/Designer和 Chiplet 鑄造廠:chiplet 設計師為 SiP OEM/設計師設計 Chiplet。設計方可能擁有晶圓廠或無晶圓廠,在後一種情況下,無晶圓廠小芯片設計人員將芯片製造外包給美國本土或海外芯粒代工廠進行製造。
AMD、NVIDIA、蘋果、高通和博通是不具備製造能力的無晶圓廠小芯片設計者的典型例子,例如,AMD、蘋果和 NVIDIA 將芯片製造外包給離岸 Chiplet Foundry 台積電。AMD 與台積電、日月光和通富微電子密切合作,以實現先進的封裝能力,例如 2.5D 封裝 [25][26], 蘋果完全依賴台積電的芯片製造和先進封裝能力;AMD 和 NVIDIA 數據中心的 GPU 依賴台積電的 CoWoS 封裝技術。其他著名的 Chiplet Foundries 包括 GlobalFoundries、Samsung、SMIC、UMC 等,它們為無晶圓廠芯片設計商提供芯片製造服務。由於當前全球的地緣政治緊張局勢,世界半導體供應鏈極易受到潛在地緣政治動盪的影響。這種衝突將影響領先的半導體公司,例如 AMD、NVIDIA 和高通等,因為台積電佔全球半導體市場份額的 56%。因此,美國需要更多投資來確保美國無晶圓廠芯片設計人員的芯片生產和/或先進封裝能力。
3)Chiplet 集成商:chiplet 集成商可以是提供全面集成服務(包括中介層設計、封裝、組裝和測試)的單一實體,也可以根據其專業知識或業務模式分為多個單獨的實體。芯片集成商主要有兩類:IDM 和 OSAT 供應商。IDM 具有端到端芯片設計、製造和封裝能力,而 OSAT 供應商僅提供封裝設計和製造能力。
在美國,Intel、Qorvo、Texas Instruments 和 Onsemi 等少數公司擁有 IDM 資格。例如,英特爾利用 Foveros 技術開發了 3D 堆疊;Qorvo 提供先進的封裝功能,例如 AiP,這對於無線通信至關重要;美光致力於內存技術和相關的先進封裝能力;諾斯羅普·格魯曼公司和霍尼韋爾公司都是致力於國防和航空航天領域的 IDM 公司。
目前美國有25家OSAT供應商,但並非所有供應商都能提供先進的封裝能力。美國最著名的 OSAT 供應商是 Amkor,但 Amkor 在美國沒有任何製造能力(圖 4)[29]。Promex 正在建設岸上先進的封裝能力。Sitronics 擁有先進的封裝能力,提供帶有增層基板的 MCM 平台,並且不使用硅中介層技術。Skywater 正在建設晶圓廠和封裝設施,以提供先進的封裝能力。美國一直是開發尖端半導體技術(包括封裝)的領導者,然而,還需要更多投資來提高本土先進封裝業務的設計和製造能力。
4)材料供應商:半導體先進封裝需要複雜的製造和工藝流程,例如切割晶圓、將其放入模具和引線鍵合、堆疊或封裝芯粒。在工藝流程的不同階段,需要不同的原材料,介電材料、引線框架、金線、密封劑和模塑料是封裝芯片最關鍵的材料。在晶圓切割步驟期間需要粘合劑和膠帶來固定晶圓,這些材料對於將製造的芯片連接到其保護封裝至關重要,並根據預期應用選擇特定的工藝和材料,例如,一種方法涉及使用鍵合線將芯片連接到引線框架,從而實現芯片和外部設備之間的數據傳輸。保護性陶瓷封裝、塑料基板或密封樹脂也可以粘合到芯片上。為了將芯片附着到封裝或基板上,需要使用聚合物和共晶合金等芯片附着材料。RDL 製造需要蝕刻劑和光刻膠化學品 。製造焊球和微凸塊需要底部填充材料。圖5解釋了典型的晶圓級封裝工藝流程,每個步驟所需的材料不同。HDMicrosystems(母公司杜邦)提供芯片的蝕刻劑、清洗液以及用於成型和封裝的密封劑。Zymet、半導體設備公司和杜邦公司提供在切割步驟中固定小芯片所需的粘合劑和膠帶。用於製造焊球和微凸塊的焊接和底部填充材料由陶氏化學、杜邦和銦泰公司提供。儘管美國有封裝所需原材料的供應商,但大部分材料由日本、中國大陸和中國台灣供應。美國目前擁有10%的半導體材料市場份額,這可能會給包括先進封裝在內的半導體供應鏈帶來漏洞。為了支持美國的先進封裝製造,需要進一步投資來確保原材料供應鏈的安全。
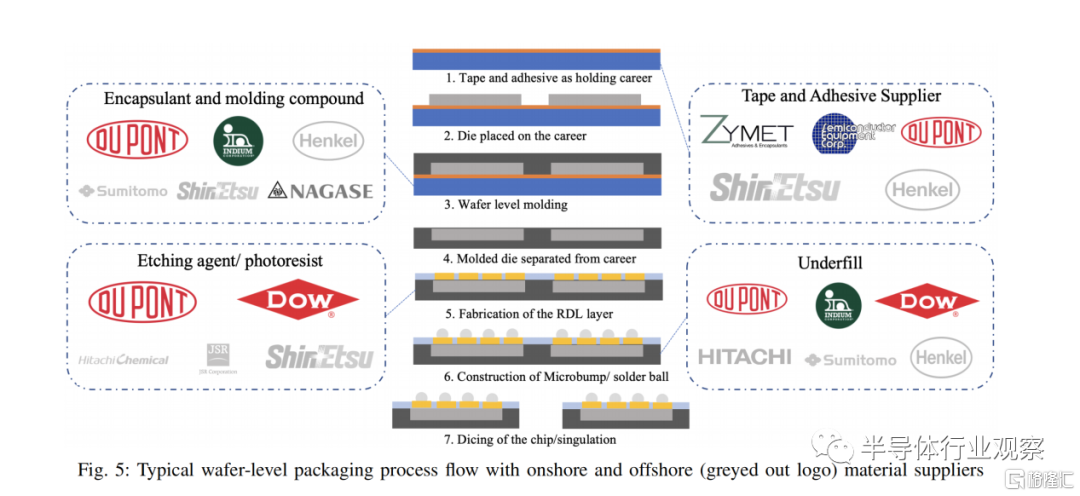
5)設備供應商:封裝製造的不同階段使用各種類型的設備,例如切割、引線鍵合、微凸塊和混合鍵合。在WLP中,需要對晶圓進行切割,然後在晶圓頂部形成RDL,此步驟需要用於芯片製造的傳統光刻設備。倒裝芯片鍵合設備通過將芯片上的焊料凸塊精確定位並鍵合到基板上相應的焊盤上,將IC芯片直接連接到基板或PCB上,從而實現高密度互連。引線鍵合設備使用金、鋁或銅製成的細線將 IC 芯片連接到基板或 PCB。它將芯片鍵合焊盤的導線連接到基板上適當的鍵合焊盤,從而實現電氣連接。芯片貼裝機將 IC 芯片放置並粘合到基板或 PCB 上,他們使用環氧樹脂或焊料等粘合材料將芯片固定在所需位置。封裝使用成型設備,在 IC 芯片周圍形成保護性封裝,該設備將芯片封裝在塑料或陶瓷材料中,提供機械保護和環境隔離。各種測試和檢驗設備用於驗證封裝 IC 的功能和質量,這包括自動光學檢測 (AOI) 系統、X 射線檢測機、電氣測試儀和其他專用測試工具。晶圓切割機將加工後的硅晶圓切割成單獨的 IC 芯片,他們利用機械或激光切割技術將晶圓切割成所需的芯片尺寸。
應用材料公司和泛林集團是美國半導體行業和先進封裝設備供應商的典型例子。除此之外,KLA、Onto Innovation、Nordson、Thermo Fisher Scientific 和 Bruker 還提供各種滿足測量需求的設備。美國公司為製造過程的各個階段提供必要的檢驗和測量工具。
6)基板和PCB供應商:基板也稱為封裝基板,是安裝IC的基礎材料,它為 IC 提供機械支撐、電氣連接和散熱。基板充當電信號在 IC 和 PCB 之間傳遞的介質,它通常由陶瓷或有機層壓板等高性能材料製成,具有導電跡線和過孔,用於在 IC 和外部電路之間建立連接。
印刷電路板 (PCB) 由非導電材料製成,例如玻璃纖維增強環氧樹脂,其上蝕刻有導電跡線圖案,它提供了一個用於安裝和互連各種電子元件(包括 IC)的平台。PCB 通常包括夾在一起的多層導電跡線和絕緣材料。當 IC 封裝安裝到 PCB 上時,封裝基板被焊接或附着到 PCB 上,從而在 IC 和 PCB 之間建立電氣連接。PCB 提供了一種將電源和信號分配給板上其他組件的方法,使 IC 能夠與電路的其他部分進行通信。
先進封裝供應鏈中的 IC 基板材料明顯短缺。這些基板在英特爾、AMD 和 Nvidia 等大公司製造的高端 CPU、GPU 和 5G 網絡芯片的封裝中發揮着至關重要的作用。目前,美國沒有本土基板供應商。
7)EDA工具供應商:芯片設計是一個高度複雜的、長期的過程,如果沒有電子設計自動化(EDA)工具的幫助,幾乎不可能創建芯片設計。EDA 工具對於先進封裝操作也很重要,各種類型的 EDA 工具用於對封裝的可靠性、封裝天線的設計以及封裝設計的許多其他方面進行建模和分析。
Cadence、Synopsys、Mentor Graphics 和 Ansys 等公司提供擴展的 EDA 工具選項來進行芯片設計和封裝。例如,Cadence 最近開始提供其 3DIC SiP 仿真工具庫存, Mentor Graphics 也是如此。藉助 Ansys,我們可以在 AiP 中建模和設計天線。因此,美國主要的 EDA 工具公司提供了設計先進封裝所需的所有工具。
8)中介層代工廠:如上一節所述,硅中介層是半導體封裝技術中的關鍵組件,負責提高芯片性能和功能。GlobalFoundries 和台積電是主要的中介層代工廠,其中,GlobalFoundries是美國最知名的中介層代工廠。例如,AMD 將 Ryzen 處理器的小芯片製造外包給台積電,這需要 7 納米等先進節點用於計算芯片,而 I/O 芯片則需要 GlobalFoundries 的舊工藝節點。GlobalFoundries 為 AMD Ryzen 處理器製造中介層,以將所有小芯片集成到不同的工藝節點中。儘管 GlobalFoundries 可以製造中介層,但由於台積電是中介層芯片的主要供應商,因此存在嚴重的海外依賴性。因此,雖然 GlobalFoundries 最近宣佈的紐約投資計劃是一項不錯的進展,但中介層芯片對海外資源的依賴仍然構成威脅。
A.US-based advanced packaging supply chain needs and capabilities in different fields.(美國先進封裝供應鏈在不同領域的需求和能力)
以下部分將評估美國公司當前和未來利用 HI(異構集成)和先進封裝製造和集成技術的能力。這些評估將用於確定美國先進封裝技術市場中僅靠國內製造設施無法支持的關鍵領域。
為了完成這些評估,我們將確定每個技術領域的具體要求,確定每個技術領域的美國 OSAT(外包組裝和測試)是否有能力利用先進封裝方法制造組件,確定美國技術市場對國外OSAT的依賴程度,併為每個技術市場提供安全評估(表 I、表 II)。在下面的分析中,我們將分析美國先進封裝能力及其與國防和航空航天、5G和通信、高性能技術、汽車、物聯網、移動、醫療和健康等各個應用領域的依賴關係。
1)國防和航空航天:航空航天和國防 (A-D) 行業面臨着獨特的挑戰,這些挑戰歸因於實現 HI(異構集成)的幾個具體特徵,例如確保封裝的高可靠性、耐用性和安全的國內供應鏈(表 I)。有 83 家值得信賴的供應商擁有國內製造設施,以確保美國國防工業的半導體供應鏈。這些供應商被認為是國防部 1 級可信供應商,包括製造設施、OSAT、IDM、SiP 設計器等。例如,Qorvo 是一家致力於滿足消費市場的半導體公司,還設計雷達應用所需的各種專用 IC (ASIC)、RFIC 和通信芯片 用於國防和航空航天領域。他們在美國的一個安全地點設計、製造、製造和封裝所有產品,以確保滿足國防工業需求的最大安全性和可靠性。雷神公司、霍尼韋爾公司、諾斯羅普格魯曼公司等國防公司也可以獲得美國IDM資格,擁有先進的封裝設施,以滿足國防工業的需求。因此,美國擁有強大的 A-D 能力來滿足需求。

2)5G 通信:5G 技術通過智能手機和物聯網 (IoT) 連接系統的普及增加了數據流量和對更快數據傳輸的需求。5G 網絡的高帶寬、低延遲應用負責提供醫療保健、交通和電力行業關鍵系統的實時反饋(表 I)。AiP 將天線結構和 RFIC 芯片集成到單個封裝中,以實現波束成形,這對於 5G 無線通信至關重要。AiP 允許將波束成形天線陣列嵌入到封裝本身中,它允許更小的設備佔用空間以及更短的 RFIC 和天線之間的佈線距離。由於天線很小,AiP 對於實現高頻應用尤其重要,它與毫米波 5G 最相關,因為它使用更高的頻段。因此,較短的互連和緊密的天線集成至關重要。
美國很少有公司能夠製造AiP及相關RFIC芯片來滿足美國5G市場的需求。Qorvo、德州儀器 (Texas Instruments)、ADI、Skyworks Solutions 和 Onsemi 是為 5G 應用開發基本芯片和封裝的典型例子。只有 Qorvo、Skyworks Solution、Analog Devices、Broadcom 和 Qualcomm 提供實現 5G 通信波束成形所必需的 AiP。其中,只有Qorvo和Skyworks Solution擁有陸上AiP製造設施。英飛凌和瑞薩擁有陸上代工廠,但它們是歐洲公司。其餘的 IDM 公司,如雷神公司、諾斯羅普格魯曼公司和霍尼韋爾公司,為國防工業的航空航天和軍事雷達應用開發和製造 AiP 和類似的解決方案,但這些解決方案無法滿足消費者市場的需求。因此,對於 5G 應用,仍然存在相當大的離岸依賴來滿足美國的需求(圖 6)。
3)高性能計算:高性能應用中對先進封裝的要求集中於實現最佳性能、可靠性和高效率(表一)。在美國,英特爾、AMD 和 NVIDIA 是高性能芯片的主要供應商,只有具有IDM資格的英特爾才能製造2.5D/3D堆疊芯片。然而,與台積電和三星等海外代工廠和 IDM 相比,它們目前在半導體工藝節點技術方面落後。AMD 和 NVIDIA 都是無晶圓廠公司,完全依賴台積電和三星等離岸晶圓廠來生產高達 5 納米的先進工藝節點。對用於加速 ML 工作的 ASIC 的需求不斷增加,例如 Google 的張量處理單元 (TPU) 或 Altera(被 Intel 收購)和 Xilinx(被 AMD 收購)的 FPGA,這些公司很大程度上依賴台積電等離岸 IDM 來製造芯片。除此之外,超級計算機和數據中心是高性能計算的主要領域之一,需要大量台積電通過切割工藝節點製造的處理器。網絡接口卡 (NIC) 對於超級計算和數據中心應用至關重要,主要由以色列公司 Mellanox Technology 提供。同樣,這些 NIC 是在台積電 (TSMC) 中製造的。這在未來可能會受地緣政治局勢的影響,從而嚴重削弱半導體行業,尤其是高性能計算應用領域,台積電和三星正在美國建設晶圓廠以滿足需求。美國仍需要對境內IDM和OSAT進行更多投資,以充分保障半導體供應鏈的安全。除此之外, ABF基板對於高性能計算應用至關重要,陸上 ABF 基材生產的缺乏可能會給高性能應用帶來重大的供應鏈風險。

4)汽車:汽車應用對先進封裝的要求主要集中在高可靠性、更長的產品生命週期和傳感器集成等關鍵因素上(表1)。2020 年末,隨着汽車市場開始復甦,汽車供應商在恢復生產能力方面遇到了困難。事實證明,重建產能是一項具有挑戰性的任務。大多數汽車集成電路採用鍵合封裝,包括 SOIC、TSSOP、QFN、QFP、BGA 和 Power Discrete。據 Yole 統計,90% 的汽車應用的封裝是由引線或層壓基板組成。基板供應短缺是汽車芯片短缺的原因之一[52]。除了這種 2.5D封裝之外,自動駕駛汽車中用於人工智能工作負載的高性能處理器也需要 3D 封裝。高性能處理器的離岸依賴是台積電和三星。自動駕駛汽車最主要的傳感系統之一的毫米波雷達,依賴 AiP技術。法雷奧(Valeo)、Robosense 和 Livox 等離岸公司主導着大部分激光雷達供應。美國激光雷達供應商 Velodyne 僅佔激光雷達市場份額的 3%。除此之外,對於激光雷達和雷達封裝來説,離岸依賴性也很大。Amkor 是美國唯一一家為汽車行業提供封裝解決方案的OSAT,但他們沒有任何在岸製造能力。因此,需要解決封裝嚴重依賴海外的問題,以確保美國汽車芯片生態系統的安全。
5) 物聯網(IoT):預計到 2030 年將有超過 5000 億台設備連接到互聯網,物聯網需要更多的異構系統來進一步推動這些應用。在設計物聯網的封裝解決方案時,一些至關重要的要求是確保封裝有低單位成本、高功效、小外形尺寸和傳感器集成(表 I)。這將使許多常用設備進一步連接世界,提高日常生活的便利性。物聯網設備應用廣泛,如醫療和健康、可穿戴設備、邊緣人工智能、自動駕駛汽車等。物聯網應用中的 5G 連接需要 AiP。扇出封裝廣泛應用於物聯網設備中的邊緣人工智能應用,以實現封裝內的高密度連接。物聯網設備通常使用 FOWLP 進行小尺寸封裝。物聯網在醫療應用中有着重要的用途,例如檢測代謝物以快速診斷健康問題。此外,用於不同物聯網應用的各種芯片在很大程度上依賴於傳統封裝。因此,物聯網應用的多種封裝技術具有相當大的離岸依賴性,需要加以解決。
6) 移動設備: 移動領域是電子產品創新的主要催化劑之一。它佔當今電子市場的很大一部分,而且最重要的是,全球 75%-80% 的人口都在使用它。在為移動應用設計封裝解決方案時,傳感器集成、低功耗、小外形尺寸和高效熱管理是首要考慮因素(表 I)。為了繼續滿足移動設備越來越小、越來越快的需求,這些設備內的封裝也必須不斷改進。移動設備中使用的 SoC 可以是 PoP 架構或 WLP,存儲芯片可以是堆疊架構。PoP 解決方案已廣泛應用於移動電話中的基帶和應用處理器。特別是高端智能手機,迅速採用了PoP封裝,因為其能夠滿足其對I/O和性能的苛刻要求。堆疊式 PoP 的主要優勢之一是,單個設備在組裝前可進行全面測試,確保實現最佳功能。移動設備中使用的許多傳感器和射頻芯片也採用了 SiP 技術。高通公司和蘋果公司是美國最著名的移動 SoC 供應商。然而,它們完全依賴台積電的先進節點來製造 SoC 並封裝解決方案。Skyworks Solution 或 Broadcom 可以提供傳感器和通信芯片。Skyworks 是一家 IDM 公司,總部設在美國。由於移動 SoC 完全依賴台積電或三星,這對供應鏈構成了重大安全威脅。
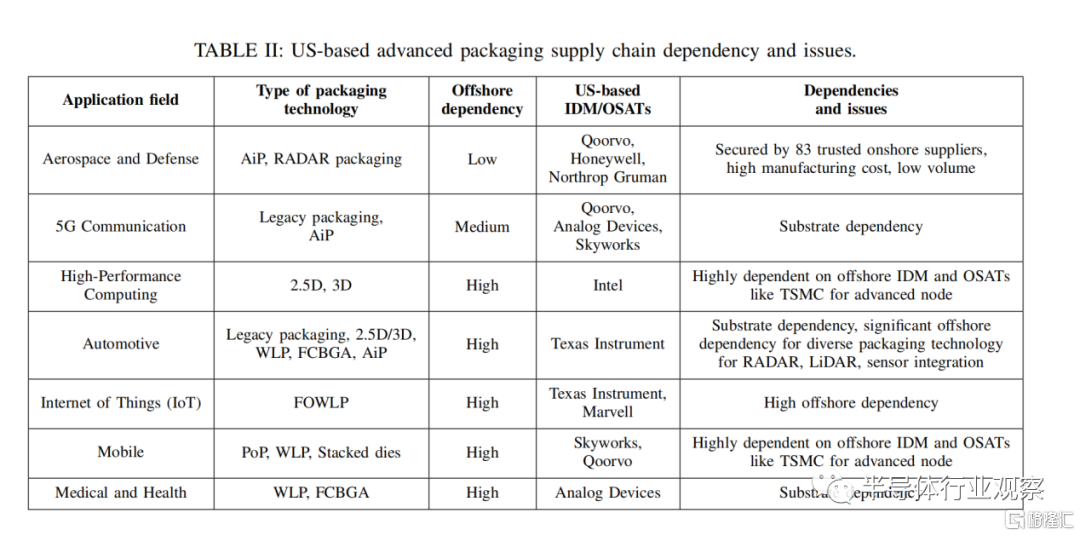
7) 醫療與健康: 醫療和健康領域是半導體芯片的重要應用領域。心臟起搏器、假肢、傳感器、醫療器械和機械等各種植入物都用於醫療應用。微型化、生物可降解和出色的電氣性能是醫療衞生應用對封裝解決方案的關鍵要求(表 I)。醫療電子產品採用了多種基底材料,包括 LTCC 等陶瓷基底、柔性電路以及 BT 樹脂和 FR-4 等層壓基底。剛性基板通常採用玻璃纖維增強材料,並與柔性基板同時使用。液晶聚合物薄膜也被用於特定設備中。今後,生物兼容基底的使用將愈發受到重視。在覆蓋材料方面,阻焊層通常用於短期應用,這些應用不含鉛,由金製成。此外,聚對二甲苯(Parylene)塗層在各種情況下也很有用。由於美國半導體封裝生態系統對基底的離岸依賴性很強,這可能會削弱醫療衞生領域的芯片供應。
B.新興的封裝和製造技術
1) 先進封裝的增材製造:快速成型製造,又稱三維打印,是一種通過逐層添加材料來製造三維物體的製造工藝。與涉及切割或加工等減法工藝的傳統制造方法不同,增材製造以數字三維模型為起點,使用專用機器製造實物。然而,最近在半導體先進封裝中,使用增材製造的趨勢越來越明顯,它具有一些明顯的優勢,如靈活性、微型化、成本效益、快速原型材料的多樣性等。在微米尺度上打印複雜特徵和結構的能力可實現高度集成封裝的開發,適應半導體行業小型化的趨勢。製造商可以利用快速原型技術快速測試新開發的封裝設計和技術。Averatek 和 Optomec 是為先進封裝提供快速成型製造技術的美國公司的典型代表。
Averatek 的 A-SAP 技術可在各種柔性基材(包括塑料、聚合物和柔性玻璃)上直接打印電路,從而無需傳統的蝕刻工藝,並可生產具有精細線寬和緊密幾何形狀的複雜電路。Optomec 公司是增材製造解決方案的領先供應商,可提供 WLP、封裝中的高頻射頻互連以及採用增材製造技術的屏蔽技術。考慮到增材製造在半導體封裝中的優勢,美國必須加大這一領域的發展力度,以滿足未來的需求。
2) 硅光子學:硅光子學是一項尖端技術,因其具有徹底改變數據通信系統的潛力,近來備受關注。它是利用硅基材料來操縱光,從而在單個芯片上集成光子元件和電子元件。這種光子學與電子學的整合具有眾多優勢,尤其是在異構集成方面。
硅光子技術在異構集成領域的一個主要優勢是能夠提供高數據傳輸速率和寬帶寬能力。傳統的集成電路封裝在將許多設備與互聯網相互連接時面臨着挑戰。然而,硅光子技術可以提供極快的數據傳輸速率和寬帶寬,實現設備之間的高效高速通信。這是通過三維堆疊封裝實現的,與傳統封裝相比,三維堆疊封裝的互連線明顯更短,從而減少了時延。此外,在單個芯片上集成光學元件與其他元件,可有效利用空間。AIM Photonics 和 Atomica 是美國公司的典範,它們在硅光子學領域表現出色,並致力於相關的封裝技術,為光通信、三維傳感、激光雷達、增強/虛擬現實 (AR/VR)、熱成像、照明和其他類型的光學傳感提供支持。
先進封裝的經濟性:美國與全球
《2022 年 CHIPS 和科學法案》旨在加強美國半導體產業,確保美國在國防和航空航天、5G 和通信、汽車、移動、醫療和健康應用以及高性能計算和物聯網系統等領域的技術解決方案的設計和開發方面處於領先地位,詳見第 III-A 節。《CHIPS 和科學法案》為商務部、國防部、國務院和國家科學基金會撥款共計 527 億美元,用於支持研究、開發、製造和勞動力發展活動,從而推動美國半導體產業的發展。其中 390 億美元用於鼓勵製造業,132 億美元用於研發和勞動力發展。此外,該法案還設立了國際技術與安全創新(ITSI)基金,提供 5 億美元用於促進安全可信的信息和通信技術,並在全球範圍內建立安全、有彈性的全球半導體制造供應鏈。
為實現《CHIPS 與科學法案》提出的願景,CHIPS 計劃辦公室宣佈計劃投資於:(i) 尖端邏輯器件;(ii) 先進封裝;(iii) 尖端存儲器件;(iv) 當前一代和成熟節點半導體。CHIPS 計劃辦公室認識到業界對傳統封裝和先進封裝的區分,並確定了傳統封裝和先進封裝執行的不同戰略。以具有經濟競爭力的方式對傳統封裝業務進行重組的困難已得到公認。因此,為確保美國在全球範圍內擁有充足和安全的常規封裝能力,重點將放在將常規封裝活動從相關國家轉移到美國的盟國和合作夥伴上。另一方面,為了在美國發展健康穩健的先進封裝能力,將在國內建立多個大規模先進封裝設施,以確保美國成為邏輯和存儲器件的商業規模的先進封裝的全球技術領導者。
全球傳統封裝業務的重新配置和國內先進封裝業務的發展,以及這兩項重大變革對支持這些業務的基礎供應鏈中的買方和供應商關係的潛在影響,都可以用價值鏈的概念來加以説明。價值鏈由設計、製造和向客户交付成品所需的一系列業務組成。價值鏈中的各項業務由一系列公司執行,可以確定一個主導公司,該公司在增值和分銷方面推動價值鏈的發展,以及一系列供應商公司,這些公司提供主導公司向客户交付產品所需的專門技術和能力。商業和經濟學文獻對價值鏈中買方和供應商的互動關係進行了研究。價值鏈可分為三類,即本地價值鏈、區域價值鏈和全球價值鏈。本地價值鏈(LVC)將一個國家內的主導企業和供應商聯繫在一起。同樣,區域價值鏈(RVCs)將單一世界區域內的主導企業和供應商連接起來,該區域可能由共同的監管制度(如歐盟)界定,或為區域成員提供優惠貿易規則(如北美自由貿易協定和東盟),或具有國家區域特徵(如拉丁美洲)。最後,全球價值鏈(GVC)將主導企業和分散在全球各地的供應商企業聯繫在一起。
如今,大多數複雜產品都是通過全球價值鏈製造的,半導體產品也是如此。將價值鏈劃分為不同階段併為每個不同階段尋找最佳地點和供應模式的做法,已將許多產品價值鏈的很大一部分從發達經濟體(如美國和歐洲)轉移到新興經濟體(如東南亞國家)。因此,如今半導體行業的大部分製造和封裝業務都在美國以外的國家進行(見表 III)。此外,一些生產流程被分割得非常細,以至於某些產品可能會多次跨越國界。例如,一塊芯片可能需要 1,000 多個加工步驟,在到達最終客户手中之前,可能要經過 70 次或更多次的國際邊境。

全球價值鏈經過數十年的持續和普遍增長與擴張,人們在過去二十年裏已認識到與全球價值鏈相關的挑戰。這些挑戰涉及低估與全球業務相關的總成本、運輸過程中庫存的資本成本、知識產權盜竊、環境影響以及確保關鍵產品供應鏈安全的必要性等等。這些挑戰使得人們有必要對全球價值鏈進行重新配置。重新定位,即把業務帶回母國,是領先企業在重新設計價值鏈時可能採用的做法之一。
從2008-2009年全球金融危機開始,企業層面的重新定位舉措如雨後春筍般湧現。服裝和鞋類、電子、汽車、機械和設備以及傢俱和家居用品等行業都出現了這種企業層面的舉措。最近,還出現了政府層面的政策干預,以鼓勵產業轉移。美國、英國、日本、法國和意大利等國政府頒佈了鼓勵產業轉移的政策工具。然而,人們也認識到,國家政府的願景、領導力和承諾需要地方政府的積極參與來支持,以制定適合當地情況的政策工具,幫助發展更短的供應鏈,這種供應鏈更依賴於當地供應商,這些供應商具備主導企業所需的專業知識、能力、技術準備和產能。
產業轉移並不是一個新概念,目前已有一些研究對產業轉移的經濟學和商業戰略進行了探討。眾所周知,當產業轉移與加強運營和升級的驅動力相關聯時,企業往往會尋求除了擁有熟練勞動力之外,還具備先進能力的當地商業和研究合作伙伴。一個強大的、蓬勃發展的供應商和支持業務網絡可以促進加速創新和持續增長。此外,與當地大學的互動不僅可以推動材料、產品、工藝和設備創新的發展,還能確保獲得技術熟練的勞動力。
企業進行離岸外包的原因引起了從業人員和學術界的廣泛關注。一些研究調查了具體國家的數據,以研究企業進行離岸外包的原因(如在美國和德國),而其他研究則側重於對這些動機進行有理論依據的解釋。根據對同行評審的英文學術期刊論文進行的內容分析,與產業轉移相關的動因和障礙大致分為五大類,分別關於全球競爭態勢、東道國、母國、供應鏈和主導企業。我們還從價值鏈分析的角度研究了重新定位的驅動因素和障礙。需要注意的是,構成企業價值鏈的所有活動可分為兩類,它們對企業的利潤率做出了貢獻:主要活動和次要活動。這些活動包括進貨物流、製造(或運營)、出貨物流、營銷和銷售以及售後服務。企業的次要活動有助於主要活動為企業創造競爭優勢,這些活動大致可分為基礎設施、人力資源管理、技術開發和採購。圖 7 從價值鏈的角度概述了轉移驅動因素和障礙,重點是企業的主要活動和次要活動。可以説,任何企業層面的先進封裝業務轉移舉措都必須考慮到這些驅動因素和障礙。
在接下來的內容中,將簡要介紹當前的舉措,並強調各種類型的夥伴關係。此外,還討論了與國家先進封裝產業發展相關的需求。
A.目前的舉措
在 COVID-19 大流行期間經歷的供應鏈失敗的後果使一些行業停滯不前或發展受阻,而《CHIPS 法案》則刺激了大量半導體制造業務的重組活動。因此,半導體設計和製造設施的建設在美國蓬勃發展。根據 Industrial Info Resources ,目前美國有價值 3000 億美元的半導體項目處於不同的開發階段,其中紐約州(1100 億美元)、亞利桑那州(860 億美元)和德克薩斯州(660 億美元)是領先的三個州。鎂光科技公司和 GlobalFoundries 是在紐約投資的公司。英特爾和 TMSC 在亞利桑那州投資。同樣,三星集團和德州儀器也在德克薩斯州投資。這些投資有望促進美國的芯片生產。
從目前的情況來看,大多數正在進行和計劃進行的投資都是圍繞美國特定的地理集羣進行的。亞利桑那州和德克薩斯州是美國半導體晶片製造的兩大歷史強州,它們吸引了大量的擴建和/或開發項目,主要原因有兩個。首先,這兩個州已經擁有完善的半導體晶圓廠生態系統。其次,這些州的地方政府通過激勵措施和促進工藝流程,表明了對半導體制造的支持。最近,俄亥俄州成為一個極具吸引力的州,其宣佈投資 200 多億美元在哥倫布地區建造晶圓廠。同樣,紐約州也提供了大量激勵措施,鼓勵建設晶圓廠。其他吸引投資的州包括印第安納州、愛達荷州、新墨西哥州、俄勒岡州、猶他州和弗吉尼亞州。
仔細研究這些新聞稿可以發現三類投資和商業發展項目。第一類是由單個公司發起和指導的項目(如美光科技公司在紐約克萊的 DRAM 工廠)。另一類項目是獨立的科技園開發和/或擴建項目,由一組公司創建共生的企業集羣(例如,印第安納州奧登市 WestGate@Crane 科技園的 NHanced Semiconductor、Everspin Technologies、Trusted Semiconductor Solutions 和 Reliable MicroSystems)。最後,還有一類項目是新建或擴建與研究型大學共建的科技園區(如印第安納州西拉法葉普渡大學發現公園區的天水科技鑄造廠)。
吸引投資的各州正在創建實體,以促進半導體生態系統的發展進程。例如,印第安納州就有兩個這樣的實體:印第安納州經濟發展公司 (IEDC) 和印第安納州區域經濟加速與發展公司 (READI)。為支持 WestGate@Crane 科技園,IEDC 以激勵性税收減免和培訓補助的形式提供支持,而印第安納州 READI 則為基礎設施開發提供支持。同樣,為支持 SkyWater-Purdue 合作項目,IEDC 正在提供有條件的税收減免、培訓補助、再發展税收減免、有條件的結構性績效付款、創新券和製造業準備補助。值得注意的是,這些激勵措施中的大多數(如果不是全部的話)都是以績效為基礎的,也就是説,企業在對促進創新的活動進行了符合條件的投資,並僱用和培訓了員工之後,才有資格申請州政府的補助。

B.先進封裝的激勵需求
在這種情況下,主要面向先進封裝業務的積極投資項目計劃似乎尚未獲得足夠的動力。如果美國不能建立一個穩固而強大的先進封裝生態系統,那麼全國各地的新生產設施所生產的芯片將不得不像以前一樣被送往海外設施進行封裝。那麼,《CHIPS 法案》將無法實現其目標,即確保從設計到製造再到封裝的整個供應鏈中的半導體業務(可在國內完成),以確保美國在下一代先進技術解決方案中的領先地位。例如,台積電最近宣佈計劃投資 29 億美元在中國台灣建立先進的芯片封裝廠,以跟上人工智能市場日益增長的需求。在美國,有必要確保類似的、甚至更有野心的投資,重點關注先進封裝業務。
首先,必須區分兩類先進封裝業務:快速原型和商業製造。用於快速原型設計的先進封裝能力將確保美國在新型和下一代先進封裝產品和技術的創新方面處於領先地位,而用於商業製造的先進封裝能力將確保美國在滿足消費者對需要先進封裝技術的產品的需求方面發揮主要作用。因此,需要有供應鏈來支持快速原型和商業先進封裝業務。
如前所述,在更廣泛的半導體生態系統中,三個代理中的一個可能會執行先進封裝操作:IDM、代工廠或 OSAT 公司。從供應鏈的角度來看,將先進封裝業務整合到 IDM 和代工廠是一種內包形式,而將 OSAT 公司作為第三方供應商則是一種外包形式。支持這兩種採購業務所需的供應鏈需要不同的供應鏈配置。對於前者,IDM 或代工廠必須擴大其供應商網絡,以提供支持先進封裝業務所需的所有材料、工具和設備。對於後者,OSAT 供應商則需要建立或擁有此類網絡。
另一個需要注意的因素是需要建立基礎設施,使材料、產品、工藝和設備技術相關的初創企業能夠在先進封裝領域進行創新。還需要建立基礎設施,使現有的微型和小型企業能夠參與發展先進封裝業務所需的供應商網絡。小微企業在轉產中的作用大多被忽視,但有令人信服的證據表明,小微企業在支持全球價值鏈轉移方面具有潛在作用[76].在這方面,發展提供無塵室製造和封裝能力的科技園區以及擔保承包等機制,對於在美國發展強大的先進封裝供應鏈尤為重要。
關於在建的晶圓廠或代工廠是否也計劃整合先進封裝業務,目前還沒有足夠的公開信息。因此,不僅需要確保 IDM 和代工廠計劃發展先進封裝業務,還需要鼓勵第三方 OSAT 企業在美國發展能力、產能並做好準備,以滿足未來對先進封裝業務的需求。
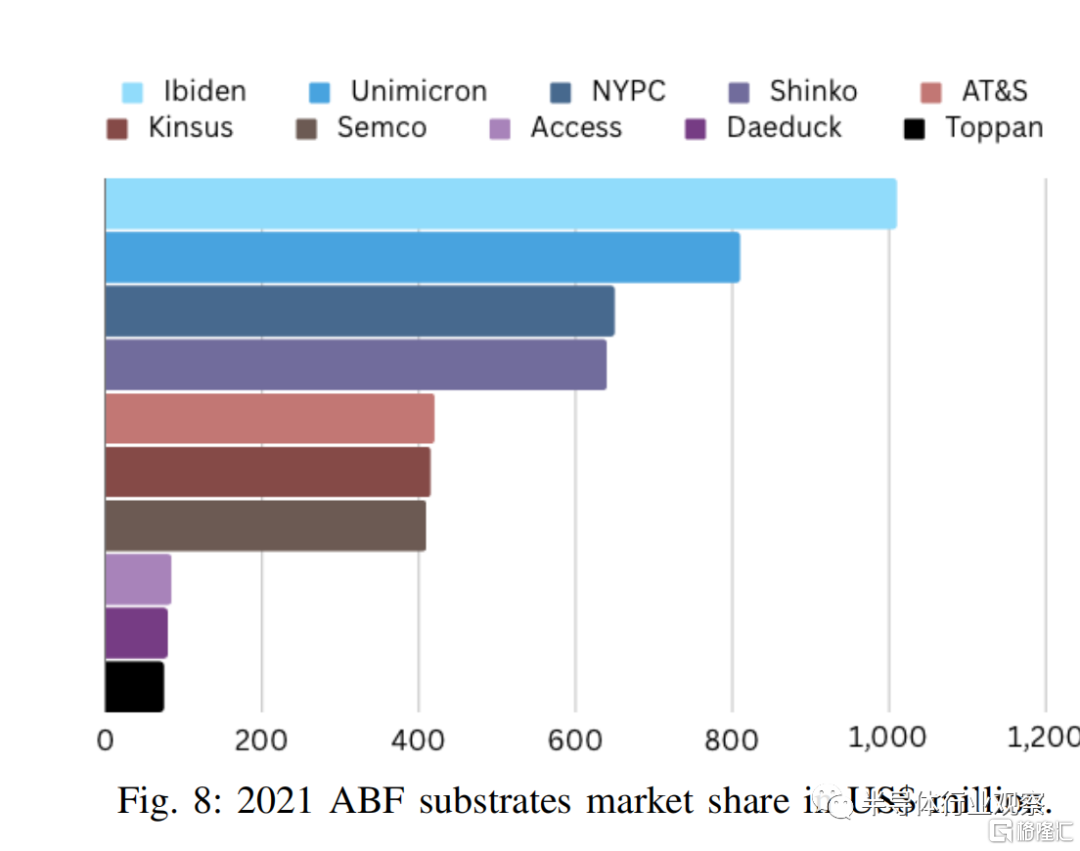
確保美國在岸先進封裝供應鏈安全的未來路線圖
A. 供應鏈問題
有許多與供應鏈相關的驅動因素促使企業進行產業轉移(見第四節),這是確保供應鏈安全的保障。然而,要全面確保供應鏈安全,就必須嚴格審查供應鏈的每個階段,從原材料一直到成品階段。為此,有必要對供應鏈進行全面摸底,不僅包括一級供應商,還包括二級供應商和原材料供應商,並確定供應商基礎有限的所有階段。可以説,如果供應鏈的某一階段只有唯一或單一供應商,那麼該階段的供應商基礎就是有限的。如果沒有其他供應商具備相同的專業知識、能力、技術準備和產能,那麼該供應商就是唯一的供應商。同樣,如果其他供應商具有相同的專業知識、能力、技術準備和產能,但供應鏈的配置是向單一供應商採購,那麼該供應商也是單一供應商。在這兩種情況下,整個供應鏈都容易受到唯一或單一供應商短缺的影響。因此,對於各個階段的供應商基地以及供應商的供應鏈來説,充分描述特定供應鏈的潛在脆弱性至關重要。這是開發安全的美國先進封裝供應鏈至關重要的第一步。接下來將介紹美國先進封裝供應鏈可能遇到的一些最關鍵瓶頸。
在這種情況下,先進封裝業務的一個主要瓶頸是集成電路襯底材料的完全離岸依賴,特別是有關 ABF 襯底。所有主要的 ABF 基板生產商,如 Ibiden、Unimicron、AT&S 等,都是離岸公司(圖 8)[100]。這些基板對英特爾、AMD 和 Nvidia 等大公司生產的高端 CPU、GPU、汽車和 5G 網絡芯片的封裝至關重要。2020 年 10 月和 2021 年 2 月,中國台灣基板生產商發生火災,進一步加劇了供應短缺。因此,特定基板出現了長達 40 周的嚴重延誤,這也是造成汽車芯片短缺的主要原因之一。由於基板供應不足,芯片供應受阻,汽車行業也因此受到影響,汽車價格飆升。引線框架和模塑化合物也是整個封裝供應鏈的主要瓶頸之一,外部企業佔據了主導地位。包括英特爾、AMD 和 Nvidia 在內的幾家主要芯片製造公司為四家著名的高端 ABF 基板製造商(即 Ibiden、Shinko、Unimicron 和 AT&S)提供了約 50% 的資金支持,以提高基板良率,解決潛在的基板稀缺問題。
另一個主要瓶頸是原材料的供應,如封裝工藝流程各階段所需的基本化學品,如濕電子化學品、溶劑、光刻膠、氣體和晶片/基板。例如,光刻膠化學蝕刻劑的供應主要依賴於離岸公司。根據亞利桑那州商務局(ACA)的報吿,美國僅佔半導體材料市場份額的 10%。美國半導體市場 31% 的超高純度化學品(如 IPA 和 H2SO4)依賴於亞洲,這使得該行業嚴重依賴於漫長、有時甚至脆弱的供應鏈。過去二十年來,美國半導體設備良率大幅下降,但由於 CHIPS 法案的實施,未來 3-5 年內芯片良率可能增加 30%,因此濕電子化學品、溶劑、光刻膠、氣體和晶圓/基板等材料,尤其是濕化學品的供應將趨緊,除非建立更多的產能,否則在不久的將來可能會成為供應鏈的關鍵和緊張因素。如果不能擴大美國的供應鏈,增加關鍵材料的國內生產,可能會阻礙芯片擴產計劃和先進封裝能力。

最後同樣重要的是,還必須關注未來如何構建美國先進封裝 OSAT 供應商市場,並制定潛在的解決方案,以緩解影響先進封裝各應用領域的主要不足(表四)。例如,在目前的格局下,TMSC 是蘋果公司唯一的先進封裝供應商。雖然從產品開發的角度來看,買家與供應商之間建立深厚而豐富的合作關係好處多多,但供應鏈風險也不容忽視。以半導體行業為例,2000 年位於阿爾伯克基的皇家飛利浦電子公司晶圓製造廠發生火災,給當時飛利浦的主要買家諾基亞和愛立信造成了重大影響。諾基亞通過應對危機和為其移動電話部門尋找替代部件供應商,得以從損失中恢復過來,但愛立信的行動卻沒有那麼迅速。2000 年第二季度,愛立信的移動電話部門出現了 2 億美元的經營虧損,愛立信無法完全從火災中恢復過來。如果愛立信當時有不止一個供應商,或者能更快地找到替代部件供應商,移動電話市場的發展可能會大不相同。因此,促進基板、原材料和製造供應供應商以及 OSAT 供應商建立深厚而廣泛的供應商基礎,以確保先進封裝業務在美國的供應鏈安全,是至關重要的。
B. 硬件安全問題
硬件安全是網絡安全的一個重要方面,它包括與系統物理組件相關的一系列潛在漏洞和威脅。即使供應鏈完全在美國境內並受到良好保護,設計和製造過程仍可能帶來安全漏洞。流氓員工等惡意行為者可能會在製造階段或供應鏈的任何環節試圖植入硬件木馬 (HT)、後門或其他惡意組件。此外,半導體制造通常涉及眾多分包商和供應商。供應鏈中每增加一個參與者,都會增加漏洞和安全缺陷的可能性,無論其位於何處。此外,儘管人們針對不同類型的硬件木馬開發了各種應對措施,但複雜攻擊的不斷演進和對第三方 IP 的依賴引發了嚴重的硬件安全問題。
另一個主要問題是逆向工程 (RE),即使美國的半導體供應鏈已完全安全並已轉為本地供應鏈,但這一問題始終存在。芯粒技術涉及通過對已製造集成電路的各器件層進行再處理和成像,提取 RTL 層的設計細節。相互競爭的半導體設計公司或敵對代工廠可能會利用逆向工程獲得競爭優勢和財務優勢。RE 活動可能導致芯粒原始設備製造商的收入損失,並引發對逆向工程芯粒可靠性和可信度的潛在擔憂。此外,與芯片類似,芯粒逆向工程也是一個耗時耗力的過程,這可能會導致對手因認為 SiP 逆向工程比芯粒逆向工程更有優勢而青睞 SiP 逆向工程。隨着半導體封裝越來越複雜,SiP RE 將日益成為新的威脅,對手將提取出芯粒之間的所有互連。因此,必須確保開展大量研究來挫敗 SiP RE,以應對知識產權盜版和克隆問題。
要有效解決上述硬件安全問題,必須採取多層次的方法。這種方法包括安全設計實踐、全面測試和驗證流程、供應鏈完整性檢查、持續監控以及在整個產品生命週期實施安全最佳實踐。加強漏洞管理,包括在整個產品生命週期內跟蹤材料和組件,對於解決這些硬件安全問題也至關重要。此外,在整個半導體價值鏈中開發和使用可信的新興技術(人工智能和機器學習方法),對於加強整個供應鏈中微電子元件和產品的安全性和出處以及提高信任度和保證度至關重要。
C. 計量需求
確保美國在岸先進封裝供應鏈的安全需要一個穩健的計量系統。計量學是一門測量科學,對於確保先進封裝技術的質量、可靠性和性能至關重要。半導體封裝日益複雜,良品率是提升先進封裝製造水平的現實問題。半導體封裝的過程控制和良品率管理在很大程度上依賴於計量和檢測工具。採用計量工具和技術來監測和控制先進封裝工藝的各個階段至關重要。這包括基板製造、芯片放置、鍵合、封裝和其他封裝步驟中的測量。工藝控制可確保一致性和符合規範,降低缺陷風險,確保封裝器件的可靠性。這些工具對於確保互連的完整性以及監控凸塊和鍵合過程的各個方面至關重要。
計量學側重於凸點工藝的直徑、高度和共面性等參數。在先進封裝中,精確的尺寸測量對於確保微電子元件的精確放置和對齊至關重要。這包括測量互連、微凸塊、凸塊下金屬化(UBM)和其他關鍵特徵的尺寸。更小的間距要求對凸點直徑和高度進行更嚴格的控制,而隨着凸點高度的降低,可接受的共平面度窗口也越來越窄。在多樣化的供應鏈中,滿足對先進封裝所用半導體材料純度、物理性能和來源的日益嚴格的要求也是必要的。要滿足這些嚴格的要求,新的測量方法和標準至關重要。計量學的這些進步將有助於確保供應鏈的質量、可靠性和安全性。此外,開發以缺陷和污染物識別為重點的測量技術、特性數據和標準,以支持整個供應鏈的統一材料質量和可追溯性,也應成為一個重要的戰略重點。
此外,由於對精度、準確性、數據集成、數字孿生等方面的需求,物理和計算計量學的突破對於推動未來設備製造技術的發展至關重要。物理和計算計量學的進步是成功製造未來一代設備所不可或缺的。這些突破可以提高精度,加強實時監控,並有能力應對與尖端技術相關的複雜性和挑戰。為確保關鍵計量技術的進步能夠跟上尖端和未來微電子和半導體制造的發展,必須改進物理和計算計量工具,以適應下一代先進複雜集成技術和系統的製造。
事實上,隨着微電子封裝的不斷髮展,新的計量技術對於集成精密元件和新型材料至關重要。在這種語境下,計量學指的是對構成先進微電子封裝的微小元件和結構進行測量和表徵的科學。由於以下幾個因素,傳統的計量方法可能無法滿足微電子封裝中使用的新興技術和材料的需求:i) 不斷縮小的特徵尺寸;ii) 多層和多材料堆疊;iii) 薄膜、表面、潛在特徵和界面的物理性質;iv) 將芯粒、電介質、片上系統 (SoC) 和存儲器集成到封裝中的方法。提供跨越多個長度尺度和物理特性的使能計量學,支持加速未來一代微電子的先進封裝概念。為複雜元件和新材料的複雜集成開發計量學是支持國內先進微電子封裝產業穩固發展的必要條件。總之,對工藝和計量工具的投資對於達到所需的質量和可靠性至關重要,特別是隨着半導體封裝複雜性的增長。
D. 勞動力發展需求
儘管美國在芯片 IP 設計和設備製造方面領先於全球市場,但由於從技術人員到設計工程師的人才嚴重短缺,美國在加強國內製造業方面面臨重大挫折。這種短缺影響重大,因為它阻礙了美國維持半導體芯片安全製造能力的能力,而半導體芯片對國防系統、自動化和量子計算至關重要。該行業的勞動力發展遇到了一些關鍵挑戰,如學生對硬件電子技術缺乏興趣、課程過時而忽視現代半導體技術、人才留存問題以及師資和基礎設施老化等。解決這些障礙對於促進該行業未來的發展和創新至關重要。為確保美國的在岸先進封裝能力,解決勞動力發展問題對於全面保障半導體供應鏈至關重要。與大型科技公司的軟件工作相比,數十年的外包導致半導體行業缺乏知名度和聲望。人們對半導體行業的認識不足,對其動態性質的瞭解有限,這加劇了人才短缺。儘管美國可以通過國際 STEM 學生獲得大量人才,但大多數工程碩士和博士生都不是美國公民。苛刻的簽證限制也導致留學生留美率低,造成了寶貴人才的流失。
為了在人才爭奪戰中保持競爭力,企業正在探索再培訓、自動化和擴大人才梯隊等戰略。然而,這些努力需要大量的時間和資金,可能不足以彌補該行業預計出現的工程師和技術人員短缺問題。此外,快節奏工廠中複雜的製造工藝導致新員工或經過再培訓的員工具有較長的學習曲線。設計工程師和質量工程師/製造技術員之間也存在收入差距,設計工程師享有更好的工作條件和更高的薪酬。這就使得重新培訓員工從事高薪文職工作具有挑戰性。另一個問題是 OSAT 利潤微薄。應提供有吸引力的薪酬來吸引封裝行業的優秀工程師。為了確保半導體和封裝技術行業未來的蓬勃發展,我們必須在國家層面投資和鼓勵年輕一代。在整個生產過程中展示自動化的優勢對於吸引年輕人的興趣至關重要。通過展示現代設備的靈活性和遠程控制能力,我們可以使這些領域對新興人才更具吸引力。總之,美國半導體行業必須解決這些與人才相關的問題,以滿足先進封裝需求並維持未來增長。
Conclusion(總結)
先進封裝與異質集成一起,是推動摩爾定律發展的關鍵因素之一。由於 CHIPS 法案的出台,政府非常重視提升本土芯片製造能力,但同樣重要的是,人們也要對先進封裝製造能力給予同樣的重視。瞭解當前美國的先進封裝供應鏈,對於找出全面保障半導體供應鏈安全和發展在岸先進封裝製造能力的瓶頸及未來方向至關重要。雖然美國擁有所有先進封裝製造能力,但為了提升本地生產能力,還需要大量投資。除了提升製造能力,確保先進封裝製造工藝所必需的原材料供應對於避免未來出現瓶頸也至關重要,如基板、模塑化合物、引線框架、蝕刻劑、光刻膠和半導體級超純原料化學品等。美國封裝基材生產的缺失,可能會影響到先進封裝的所有應用領域,亟待解決。解決了供應鏈中的所有這些薄弱環節,美國的先進封裝供應鏈才能得到保障。
本文由電子科技大學長三角研究院(湖州)集成電路與系統中心黃樂天老師指導電子科技大學“強芯鑄魂”計劃成員馮夢奇同學完成翻譯。“強芯鑄魂”計劃是電子科技大學依託學校在集成電路領域的優勢學科資源和產教融合資源,充分發揮電子薄膜與集成器件全國重點實驗室、國家集成電路產教融合創新平台的能量,聚焦集成電路設計、製造工藝、先進封裝以及EDA等核心關鍵技術,實施的本研貫通培養特別行動計劃。期望為我國探索出一條“快出人才,出高質量人才”的人才培養新路。



